英特尔在前沿技术领域的探索和布局具有行业标杆意义,其发布的技术路线图和成果为半导体行业提供了重要参考方向。
在IEDM 2024大会上,英特尔发布了7篇技术论文,展示了多个关键领域的创新进展。这些技术涵盖了从FinFET到2.5D和3D封装(EMIB、Foveros、Foveros Direct),即将在Intel 18A节点应用的PowerVia背面供电技术,以及全环绕栅极(GAA)晶体管RibbonFET等。此外,英特尔还揭示了一些面向未来的先进封装技术,为推动行业发展提供了新的视角。
在这些前沿技术中,三个核心领域尤为值得关注:面向AI发展的先进封装、晶体管微缩技术和互连微缩技术。在IEDM 2024大会上,英特尔代工高级副总裁兼技术研究总经理Sanjay Natarajan详细介绍了这些领域的关键突破。

先进封装的突破:选择性层转移技术
异构集成已经成为当今芯片界的主流实现性能提升的手段。但是异构集成技术面临着很大的挑战。当前异构集成技术主要采用“晶圆对晶圆键合”(Wafer-to-Wafer HB)或“芯片对晶圆键合”(Chip-to-Wafer HB),会因顺序装配芯粒而导致吞吐量、芯片尺寸和厚度受限。
英特尔通过选择性层转移(Selective Layer Transfer)技术,突破了当前异构集成的技术瓶颈。这项技术能够以超高效率完成超过15,000个芯粒的并行转移,仅需几分钟即可实现相较于传统方法数小时或数天的提升。其创新性地实现了亚微米级芯粒的转移,支持仅1平方毫米大小、厚度为人类头发1/17的芯粒。这提供了一种灵活且成本效益显著的异构集成架构,使得处理器与存储器技术的混合搭配成为可能。Intel Foundry率先采用无机红外激光脱键技术,实现了芯粒转移的技术突破,推动了旗舰AI产品开发所需的先进异构集成技术的发展。
英特尔代工高级副总裁技术研究总经理Sanjay Natarajan表示:“我们有理支持;2)持续增加晶体管数量的技术是可行的,但能源效率的革命性突破将是未来发展的重点。

互连缩放的突破:钌线路
随着晶体管和封装技术的持续微缩,互连已成为半导体体系中的第三个关键要素。这些互连导线负责连接数以万亿计的晶体管。然而,我们清晰地看到,铜互连的时代正逐渐走向尾声。铜互连存在一个实际问题:使用时需要添加阻挡层和籽晶层。随着尺寸的不断缩小,这些相对高电阻的层占据了更多的可用空间。英特尔观察到,当线宽不断缩小时,铜线的电阻率呈指数级上升,达到难以接受的程度。因此,尽管晶体管尺寸越来越小、密度和性能不断提升,但传统的布线方式已无法满足连接所有晶体管的需求。
英特尔的突破在于采用具有高成本效益的空气间隙钌(Ru)线路,作为铜互连的潜在替代方案。这个空气间隙解决方案无需昂贵的光刻技术,也不需要自动对准通孔工艺。它巧妙地将空气间隙、减法钌工艺和图案化相结合,有望打造出合理的下一代互连技术,使之与未来的晶体管和封装技术相匹配。
这种新工艺在小于25nm的间距下,实现了在匹配电阻条件下高达25%的电容降低,有效提升了信号传输速度并减少了功耗。高分辨率的显微成像展示了钌互连线和通孔的精确对齐,验证了没有发生通孔突破或严重错位的问题。减法钌工艺支持大规模生产(HVM),通过消除复杂的气隙排除区和选择性蚀刻需求,具备实际应用的经济性和可靠性。
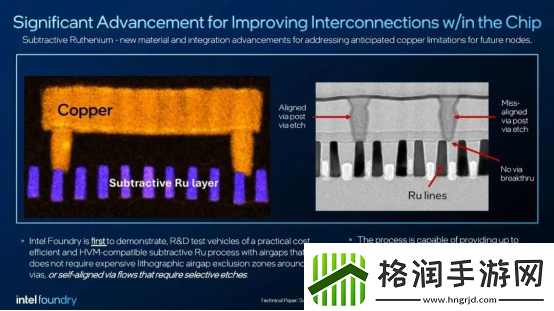
写在最后
半导体产业是一个高度复杂的生态系统,需要各方共同努力才能取得突破。英特尔在封装、晶体管和互连等领域的创新成果,为整个行业提供了宝贵的经验和启示。如同Sanjay Natarajan所述,英特尔的目标是为整个行业提供路线图,以协调和统一我们所有的研发资金和努力。这样,下一代产品和服务就能推动整个行业向前发展,并继续推进摩尔定律。英特尔确实始终将自己视为摩尔定律的守护者,致力于承担这一责任,不断探索推进摩尔定律的新技术。这不仅是为了英特尔的利益,更是为了整个行业的共同利益。

